| 基板タイプ | プリント基板 ビルドアップ基板 フレシキブル基板 |
LTCC セラミック基板 |
TAB/COF テープ基板 |
備考 | ||
| 加工装置 | ラック 全自動 |
ラック 全自動/半自動 |
フープ 全自動 |
|||
| 加工サイズ (mm) |
510×600 | 200×200 | 材料厚/ 0.025~0.125 材料巾/ 35~165 |
めっき仕様により条件変更有 | ||
| 電 解 |
Ni(厚み:µm) | 光沢 | (3~5) |
|||
| 半光沢 | (3~5) |
|||||
| 無光沢 | (3~5) |
(2~5) |
(0.1~10)※1 |
※1 スルファミン酸系を使用しています。 | ||
| Au(厚み:µm) | 純金 | (0.5) |
(0.1~) |
(~1) |
ワイアーボンディング用 Au/Au接合 |
|
| 硬質 | (0.03~1.0) |
接点用 | ||||
| 無 電 解 |
Ni(厚み:µm) | Ni-P | (2~5) |
(2~5) |
中Pタイプ | |
| Au(厚み:µm) | 薄付 | (0.03~0.05) |
(0.03~0.05) |
表面実装用 半田付け用 |
||
| 厚付 | (0.1~0.5) |
(0.1~0.8) |
ワイアーボンディング用 Au/Au接合 |
|||
| パラジウム(厚み:µm) | 無電解 | (0.1~) |
(0.1~) |
金めっきと組み合わせ使用 | ||
| 各仕様組合わせでのコンビめっき、部分めっき加工承ります。 | 厚膜印刷基板(Ag系配線)専用工程です。 Cu、W等承ります。 |
無電解Snめっき、レジスト印刷加工も承ります。 | ||||
電解タイプ
| めっき仕様 | 対応めっき厚(μm) | 生産能力 | ワークサイズ(mm) |
| 無光沢Ni/純Au | Ni 0.50〜10.0 | 15,000枚/日 | 一般仕様 100 × 100 〜510 × 600 (MAX 1,000 × 1,000) |
| Au 0.03〜1.0 | |||
| 半光沢Ni/純Au | Ni 0.50〜10.0 | ||
| Au 0.03〜1.0 | |||
| 無光沢Ni/硬質Au | Ni 0.50〜10.0 | 3,000枚/日 | |
| Au 0.03〜1.0 | |||
| 半光沢Ni/硬質Au | Ni 0.50〜10.0 | ||
| Au 0.03〜1.0 | |||
| 半光沢Ni/光沢Ag | Ni 0.50〜10.0 | 2,000枚/日 | |
| Ag 0.50〜3.0 | |||
| 無光沢Niのみ | Ni 0.50〜10.0 | 1,000枚/日 | |
| 半光沢Niのみ | Ni 0.50〜10.0 | ||
| ダイレクト 純Au | Au 0.03〜1.0 | ||
| ダイレクト 硬質Au | Au 0.03〜1.0 | ||
| ダイレクト 光沢Ag | Ag 0.50〜3.0 | ||
| 部分Au/光沢Ag ※1 | 各仕様による | 各仕様による | |
| 2色めっき ※2 | 〃 | 〃 |
電解めっきは、弊社専用の給電接点が必要になります。事前にお打合せを御願い致します。上記対応めっき厚以外にも、ご相談頂ければ処理は可能です。
※1 部分めっきは、マスク治具・テープマスクによるめっきの他、リード接続部のみの厚付も可※2 用途に合わせた組み合わせで、片面ずつ別の仕様でめっきが可能例)
その他の仕様についても、お問合せ下さい。
無電解タイプ
| めっき仕様 | めっき種類 | 対応めっき厚(μm) | 生産能力 | ワークサイズ(mm) |
| Ni/薄付けAu | Ni | 2〜10 | 5,000枚/日 | 100 × 100〜 610 × 710 |
| 置換Au | 0.02〜0.08 | |||
| Ni/薄付けAu (低腐食型置換Au) | Ni | 2〜10 | ||
| 低腐食型置換Au | 0.02〜0.08 | |||
| 部分Ni/薄付けAu (DF対応) | Ni | 2〜10 | 1,000枚/日 | 100 × 100〜 610 × 710 |
| 低腐食型置換Au | 0.02〜0.08 | |||
| Ni/Pd/Au (置換Au) 3層仕様 | Ni | 2〜10 | 5,000枚/日 | 100 × 100〜 570 × 870 |
| Pd | 0.02〜1.0 | |||
| 置換Au | 0.02〜0.04 | |||
| Ni/Pd/Au (置換厚付けAu) 3層仕様 | Ni | 2〜10 | ||
| Pd | 0.02〜1.0 | |||
| 置換厚付けAu | 0.05〜0.3 | |||
| Ni/Pd/Au (置換Au + 還元Au) 4層仕様 | Ni | 2〜10 | 2,000枚/日 | 100 × 100〜 570 × 870 |
| Pd | 0.02〜1.0 | |||
| 置換Au + 還元Au | 0.05〜0.5 | |||
| Ni/厚付けAu (還元Au) | Ni | 2〜10 | 5,000枚/日 | 100 × 100〜570 × 870 |
| 還元Au | 0.05〜1.0 | |||
| ダイレクトAu | 置換Au | 0.02〜0.15 | 1,000枚/日 | 100 × 100〜 610 × 710 |
プリント基板/ビルドアップ基板/フレキシブル基板用金めっき加工
無電解NiめっきP濃度 VS ターン数
電解 VS 無電解Auめっき(Ni:5µm、Au:0.5µm)
LTCC基板(セラミック基板)用金めっき加工
LTCC基板のAg系配線への無電解金めっき加工(下地Niめっき)承ります。
耐熱仕様にて、Ni/Pd/Au3層めっきも可能です。
Wafer検査装置
膜厚測定:高精度蛍光X線膜厚計
測定装置:日立ハイテクサイエンス製 FT150

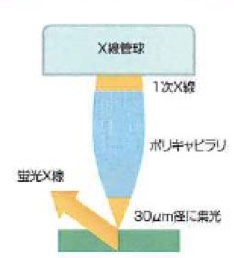
- 薄膜の膜厚測定を高速で簡便に行える最新機種を導入
- ビーム径を30μm まで絞ることができ、100μm を下回る微小Pad の膜厚測定が可能
- 多層膜の測定スピードは従来機種と比較して2倍以上に高速化
外観検査:金属顕微鏡
測定装置:ニコンインステック製 ECLIPSE L300N

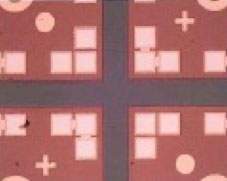

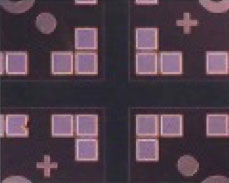
- ウェハー専用ステージを備えた、外観検査装置として実績の高い機種を導入
- 明視野、暗視野、微分干渉など各種観察方法に対応
外観検査:ウェハローダー
測定装置:ニコンインステック製 NWL200TMB86(6,8inch 対応)

- ウェハの外観のマクロ検査や裏面検査を行い、ウェハを自動で顕微鏡ステージに搬送する装置を導入
- ノッチやオリフラの方向合わせも可能
治工具類の活用
ウェハ移載機

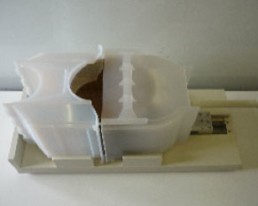
ノッチアライナー